Чем определяется высота потенциального барьера р n перехода
Электронно-дырочный переход
Граница между двумя соседними областями полупроводника, одна из которых обладает проводимостью n-типа, а другая p-типа, называется электронно-дырочным переходом (p-n-переходом). Он является основой большинства полупроводниковых приборов. Наиболее широко применяются плоскостные и точечные p-n-переходы.
Плоскостной p-n-переход представляет собой слоисто-контактный элемент в объеме кристалла на границе двух полупроводников с проводимостями p- и n-типов
(рис. 1.2, а). В производстве полупроводниковых приборов и интегральных микросхем применяются переходы типа р+- n- или р- п+ переходы. Индекс «+» подчеркивает большую электропроводность данной области монокристалла.
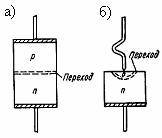
Рис. 1.2 Плоскостный (а) и точечный (б) p-n переходы
Рассмотрим физические процессы в плоскостном p-n-переходе (рис. 1.3). Поскольку концентрация электронов в полупроводнике n-типа значительно больше, чем в полупроводнике p-типа и, напротив, в полупроводнике p-типа высокая концентрация дырок, то на границе раздела полупроводников создается перепад (градиент) концентрации дырок dp/dx и электронов dn/dx. Это вызывает диффузионное перемещение электронов из n-области в p-область и дырок в противоположном направлении. Плотности дырочной и электронной составляющих диффузионного тока, обусловленных перемещением основных носителей, определяются выражениями:
где Dn и Dp – коэффициенты диффузии соответственно электронов и дырок.

Электрический заряд дырки в формуле (1.7) принят равным электрическому заряду электрона, но противоположного знака, а знак «—» при dp/dx и dn/dx указывает, что диффузия идет в сторону уменьшения концентрации.
В результате ухода электронов из приконтактной области n-типа и дырок из приконтактной области p-типа на этих участках образуется обедненный от подвижных носителей заряда слой и появляется нескомпенсированный положительный заряд за счет ионов донорной примеси (в приконтактной области n-типа) и отрицательный заряд за счет ионов акцепторной примеси (в приконтактной области p-типа). Обедненный слой представляет таким образом область полупроводника с соответствующей плотностью объемного заряда, наличие которого приводит к образованию электрического поля (на рис. 1.3 направление напряженности этого поля отражено вектором E, препятствующего дальнейшему диффузионному перемещению электронов из полупроводника n-типа в полупроводник р-типа и дырок в противоположном направлении. Поскольку обедненный слой обладает малой электропроводностью, так как в нем практически отсутствуют подвижные носители заряда, его еще называют запирающим слоем.
Под действием электрического поля через p-n-переход могут перемещаться (дрейфовать) лишь неосновные носители, т. е. дырки из полупроводника n-типа и электроны из полупроводника p-типа, которые обусловливают дрейфовый ток. Плотность дырочной и электронной составляющих дрейфового тока можно определить, воспользовавшись значениями проводимостей собственного полупроводника из выражения (1.6):
Общая плотность тока через p-n-переход определяется суммой диффузионных и дрейфовых составляющих плотностей токов, которые при отсутствии внешнего напряжения равны. Так как диффузионный и дрейфовый потоки зарядов через p-n-переход перемещаются во встречном направлении, то они компенсируют друг друга. Поэтому в равновесном состоянии общая плотность тока через p-n-переход равна
Наличие двойного электрического слоя обусловливает возникновение в p-n-переходе контактной разности потенциалов, претерпевающей наибольшее изменение на границе полупроводников n-p-типов и называемой потенциальным барьером jк. Величина потенциального барьера определяется уравнением
где jТ = kT/q – тепловой потенциал (при нормальной температуре, т. е. при T =300 К jТ » » 0,026 В); рп и np – концентрация дырок и электронов в полупроводниках n- и р-типов. У германиевых переходов jТ = (0,3 – 0,4) В, у кремниевых jТ = (0,7 – 0,8) В.
Если подключить к p-n-переходу источник внешнего напряжения таким образом, чтобы плюс был приложен к области полупроводника n-типа, а минус – к области полупроводника p-типа (такое включение называют обратным, рис. 1.4), то обедненный слой расширяется, так как под воздействием внешнего напряжения электроны и дырки смещаются от p-n-перехода в разные стороны. При этом высота потенциального барьера также возрастает и становится равной jк+ u (рис. 1.5), поскольку напряжение внешнего смещения включено согласно контактной разности потенциалов.
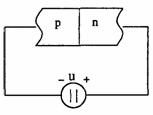
Рис 1.5 Изменение потенциального барьера
Так как напряжение внешнего источника прикладывается встречно контактной разности потенциалов, то потенциальный барьер снижается на величину u (см.
рис. 1.7), и создаются условия для инжекции основных носителей – дырок из полупроводника p-типа в полупроводник n-типа, а электронов – в противоположном направлении. При этом через p—n-переход протекает большой прямой ток, обусловленный основными носителями заряда. Дальнейшее снижение потенциального барьера ведет к росту прямого тока при неизменном значении обратного дрейфового тока.
В процессе технологической обработки кристалла примесь вводится таким образом, что ее концентрация, а следовательно, концентрация основных носителей в одной из областей кристалла (обычно в полупроводнике p-типа) на два-три порядка превышает концентрацию примеси в другой области. Область с высокой концентрацией примеси (низкоомная область) является основным источником носителей подвижных зарядов через p—n-переход и называется эмиттером. Область с низкой концентрацией примеси является высокоомной и называется базой. Поэтому доминирующей составляющей прямого тока, протекающего через p—n-переход и состоящего из электронной и дырочной составляющих, будет та, которая определяется основными носителями зарядов области с более высокой их концентрацией
При |Uпр| >> jТ переход по существу исчезает и ток ограничивается лишь сопротивлением (единицы и даже десятки ом) базовой области rб.
Вольтамперная характеристика (ВАХ) p—n-перехода, построенная на основании выражений (1.10) и (1.11), имеет вид, показанный на рис. 1.8. Область ВАХ, лежащая в первом квадранте, соответствует прямому включению p—n-перехода, а лежащая в третьем квадранте – обратному. Как отмечалось выше, при достаточно большом обратном напряжении возникает пробой перехода. Пробоем называют резкое изменение режима работы перехода, находящегося под обратным напряжением.
Характерной особенностью этого изменения является резкое уменьшение дифференциального сопротивления перехода r диф = du / di ( u и i – напряжение на переходе и ток перехода соответственно). После начала пробоя незначительное увеличение обратного напряжения сопровождается резким увеличением обратного тока. В процессе пробоя ток может увеличиваться при неизменном и даже уменьшающемся (по модулю) обратном напряжении (в последнем случае дифференциальное сопротивление оказывается отрицательным). На ВАХ перехода (рис. 1.9) пробою соответствует область резкого изгиба характеристики вниз в третьем квадранте.
Рис. 1.8 Вольтамперная характеристика (а) и схема включения стабилитрона (б)
Различают три вида пробоя p-n-перехода: туннельный, лавинный и тепловой. И туннельный, и лавинный пробой принято называть электрическим пробоем.
Механизм лавинного пробоя подобен механизму ударной ионизации в газах. Лавинный пробой возникает, если при движении до очередного соударения с атомом дырка (или электрон) приобретает энергию, достаточную для ионизации атома. В результате число носителей резко возрастает, и ток через переход растёт. Расстояние, которое проходит носитель заряда до соударения, называют длиной свободного пробега. Лавинный пробой имеет место в переходах с высокоомной базой (имеющей большое удельное сопротивление). Характерно, что при этом пробое напряжение на переходе мало зависит от тока через него (крутопадающий участок в третьем квадранте ВАХ, см. рис. 1.9).
При тепловом пробое увеличение тока объясняется разогревом полупроводника в области р-n-перехода и соответствующим увеличением удельной проводимости. Тепловой пробой характеризуется отрицательным дифференциальным сопротивлением. Если полупроводник – кремний, то при увеличении обратного напряжения тепловой пробой обычно возникает после электрического (во время электрического пробоя полупроводник разогревается, а затем начинается тепловой пробой). После электрического пробоя p-n-переход не изменяет своих свойств. После теплового пробоя, если полупроводник успел нагреться достаточно сильно, свойства перехода необратимо изменяются (полупроводниковый прибор выходит из строя).
Как уже отмечалось, вследствие диффузии электронов и дырок через p-n-переход в области перехода возникают нескомпенсированные объемные (пространственные) заряды ионизированных атомов примесей, которые закреплены в узлах кристаллической решетки полупроводника и поэтому не участвуют в процессе протекания электрического тока. Однако объемные заряды создают электрическое поле, которое, в свою очередь, самым существенным образом влияет на движение свободных носителей электричества, т. е. на процесс протекания тока.
Изменение внешнего напряжения, приложенного к p-n-переходу, изменяет величину объемного пространственного заряда обедненного слоя. Следовательно, p-n-переход ведет себя как плоский конденсатор, емкость которого, определяемая отношением изменения пространственного заряда ¶Q к изменению напряжения ¶U при обратном включении перехода, называется барьерной и может быть найдена из уравнения
где e0 – диэлектрическая проницаемость вакуума; e – относительная диэлектрическая
p–n переход и его электрические свойства
Электронно-дырочный переход (p–n переход).
Для создания в исходном полупроводнике (обычно 4-валентном германии или кремнии) проводимости n- или p-типа в него добавляют атомы 5-валентной или 3-валентной примесей соответственно (фосфор, мышьяк или алюминий, индий и др.)
Атомы 5-валентной примеси (доноры) легко отдают один электрон в зону проводимости, создавая избыток электронов в полупроводнике, не занятых в образовании ковалентных связей; проводник приобретает проводимость n-типа. Введение же 3-валентной примеси (акцепторов) приводит к тому, что последняя, отбирая по одному электрону от атомов полупроводника для создания недостающей ковалентной связи, сообщает ему проводимость p-типа, так как образующиеся при этом дырки (вакантные энергетические уровни в валентной зоне) ведут себя в электрическом или магнитном полях как носители положительных зарядов. Дырки в полупроводнике р-типа и электроны в полупроводнике n-типа называются основными носителями в отличие от неосновных (электроны в полупроводнике р-типа и дырки в полупроводнике n-типа), которые генерируются из-за тепловых колебаний атомов кристаллической решетки.
Если полупроводники с разными типами проводимости привести в соприкосновение (контакт создается технологическим путем, но не механическим), то электроны в полупроводнике n-типа получают возможность занять свободные уровни в валентной зоне полупроводника р-типа. Произойдет рекомбинация электронов с дырками вблизи границы разнотипных полупроводников.
Потенциальный барьер в p-n переходе.
Если к полупроводнику приложить электрическое напряжение, то в зависимости от полярности этого напряжения р-n-переход проявляет совершенно различные свойства.
Свойства p-n перехода при прямом включении.
Свойства p-n перехода при обратном включении.
Итак, с определенной долей приближения можно считать, что электрический ток через р-n-переход протекает, если полярность напряжения источника питания прямая, и, напротив, тока нет, когда полярность обратная.
По этой же причине выше предельная рабочая температура полупроводника. Для германия она составляет 80º С, кремний: 150º С, арсенид галлия: 250º С (DE = 1,4 эВ). При большей температуре количество носителей заряда возрастает, сопротивление кристалла уменьшается, и полупроводник термически разрушается.
Вольт-амперная характеристика p-n перехода.
Вольт-амперная характеристика (ВАХ) является графической зависимостью протекающего через р-n переход тока от приложенного к нему внешнего напряжения I=f(U). Вольт-амперная характеристика р-n перехода при прямом и обратном включении приведена ниже.

Напряжение от внешнего источника, подведенное к кристаллу с р-п переходом, практически полностью сосредотачивается на обедненном носителями переходе. В зависимости от полярности возможны два варианта включения постоянного напряжения — прямое и обратное.
ВАХ p-n перехода описывается аналитической функцией:
U — приложенное к переходу внешнее напряжение соответствующего знака;
Iо = Iт — обратный (тепловой) ток р-п перехода;
Краткие теоретические сведения



ЛАБОРАТОРНАЯ РАБОТА № 1
Исследование свойств контакта полупроводников n- и p- типа с одинаковой шириной запрещённой зоны
Краткие теоретические сведения
Основным элементом большинства полупроводниковых приборов является электронно-дырочный переход (р-n-переход), представляющий собой переходный слой между двумя областями полупроводника, одна из которых имеет электронную электропроводность, а другая — дырочную.
Образование p-n—перехода. P-n—переход в равновесном состоянии.


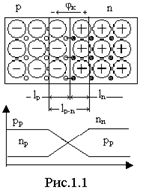
P-n-переход характеризуется двумя основными параметрами:
Высота потенциального барьера. Она равна контактной разности потенциалов jк. Это разность потенциалов в переходе, обусловленная градиентом концентрации носителей заряда. Это энергия, которой должен обладать свободный заряд, чтобы преодолеть потенциальный барьер:
где k – постоянная Больцмана, q – заряд электрона, T – температура, Nа и Nд – концентрации акцепторов и доноров в дырочной и электронной областях соответственно, pp и pn – концентрации дырок в p— и n-областях соответственно, ni – собственная концентрация носителей заряда в нелегированном полупроводнике, 
Ширина p-n-перехода (рис.1.1) – это приграничная область, обеднённая носителями заряда, которая располагается в p— и n-областях
В равновесном состоянии (без внешнего напряжения) через р-n-переход движутся два встречных потока зарядов (протекают два тока). Это дрейфовый ток неосновных носителей заряда и диффузионный ток, который связан с основными носителями заряда. Так как внешнее напряжение отсутствует, и тока во внешней цепи нет, то дрейфовый ток и диффузионный ток взаимно уравновешиваются и результирующий ток равен нулю:
Это соотношение называют условие динамического равновесия процессов диффузии и дрейфа в изолированном (равновесном) p-n-переходе.
Р-n—переход в неравновесном состоянии (при внешнем напряжении, приложенном к нему).
Внешнее напряжение нарушает динамическое равновесие токов в p-n-переходе. P-n-переход переходит в неравновесное состояние. В зависимости от полярности напряжения приложенного к областям в p-n-перехода возможно два режима работы.
Прямое смещениеp-n-перехода. Р-n-переход считается смещённым в прямом направлении, если положительный полюс источника питания подсоединен к р-области, а отрицательный к n-области (рис.1.2)
При прямом смещении, напряжения jк и U направлены встречно, результирующее напряжение на p-n-переходе убывает до величины jк — U. Это 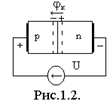

При протекании прямого тока основные носители заряда р-области переходят в n-область, где становятся неосновными. Диффузионный процесс введения основных носителей заряда в область, где они становятся неосновными, называется инжекцией, а прямой ток – диффузионным током или током инжекции. Для компенсации неосновных носителей заряда накапливающихся в p— и n-областях во внешней цепи возникает электронный ток от источника напряжения, т.е. принцип электронейтральности сохраняется.
При увеличении U ток резко возрастает, 
Обратное смещение p-n-перехода возникает когда к p-области приложен минус, а к n-области плюс, внешнего источника напряжения (рис.1.3).
Этот ток мал по величине т.к. связан с неосновными носителями заряда, концентрация которых мала. Таким образом, p-n-переход обладает односторонней проводимостью.
При обратном смещении концентрация неосновных носителей заряда на границе перехода несколько снижается по сравнению с равновесной. Это приводит к диффузии неосновных носителей заряда из глубины p— и n-областей к границе p-n-перехода. Достигнув её неосновные носители попадают в сильное электрическое поле и переносятся через p-n-переход, где становятся основными носителями заряда. Диффузия неосновных носителей заряда к границе p-n-перехода и дрейф через него в область, где они становятся основными носителями заряда, называется экстракцией. Экстракция и создает обратный ток p-n-перехода – это ток неосновных носителей заряда.
Величина обратного тока сильно зависит от температуры окружающей среды, материала полупроводника и площади p-n-перехода.
Тепловой ток кремниевого перехода много меньше теплового тока перехода на основе германия
Потенциальный барьер р – n перехода
Теоретические замечания
Введение
Электронно-дырочный переход является основой таких электронных приборов, как полупроводниковый диод и биполярный транзистор. Существует целый ряд разновидностей полупроводниковых диодов, различающихся по характеристикам и функциональному назначению: выпрямительные, детекторные, импульсные диоды, варикапы, стабилитроны, туннельные диоды, лавинно-пролетные диоды (ЛПД) и другие. Все они содержат p ‑ n переход, но различаются конструкцией, размерами, типами полупроводниковых материалов, концентрацией примеси, профилем легирования. В первых трех типах упомянутых диодов используется нелинейность вольт – амперной характеристики (ВАХ), заключающаяся в резком различии сопротивления для прямого и обратного направления тока. Применение варикапов основано на зависимости барьерной емкости от приложенного напряжения. В стабилитронах и ЛПД используется явление пробоя p – n перехода, которое здесь не рассматривается.
Электронно-дырочный (p – n) переход
Проводимость полупроводника обусловлена наличием носителей заряда двух видов: электронов (заряд -е) в зоне проводимости и дырок (заряд +е) в валентной зоне. В собственном полупроводнике (без примесей) концентрации свободных электронов n и дырок p всегда равны
где ni –собственная концентрация свободных носителей.
Введение в полупроводник примеси нарушает это равновесие. Примесь может быть донорной. Тогда n > p и такой полупроводник называется электронным или n – типа. Примесь может быть акцепторной и тогда p > n. Такой полупроводник называется дырочным или p – типа. Носители с преобладающей концентрацией называются основными, а с меньшей концентрацией – неосновными.
Электронно-дырочным или p – n переходом называется контакт двух примесных полупроводников с различным типом проводимости. Такой контакт создается, например, путем внесения в одну область чистого (собственного) полупроводника донорной примеси, а в другую область – акцепторной, или путем введения в однородный примесный полупроводник с каким-либо типом электропроводности примеси, создающей другой тип электропроводности. Для этого используются специальные технологии (вплавление, диффузия, молекулярно-лучевая имплантация, жидкофазная эпитаксия, ионное легирование).
Рис. 1
Обозначим концентрацию примеси Nnpв n – области через Nd, а в p – области через Nа. Схематически p – n переход показан на рис.1,а.
На рис. 1,б и 1,в показаны некоторые возможные случаи распределения концентрации примеси Nnp в n – и p – областях. Концентрация акцепторной примеси условно отложена вверх, а донорной – вниз от оси х. Переход может быть резким (рис. 1,б) или плавным (рис. 1,в). При условии Na = Nd переход называется симметричным, в противном случае – несимметричным.
В широком интервале обычных температур все атомы примеси ионизованы и создают добавочную примесную концентрацию свободных электронов Nd в n – области и дырок Na в р – области. Следовательно, в n – области будут преобладать свободные электроны, которые называются основнымносителями, а дырки – неосновными. В p – области основными носителями заряда будут дырки, концентрация которых значительно больше, чем концентрация свободных электронов.
Будем считать, что полупроводник достаточно сильно легирован, так что Nd >> ni, Na >> ni, где ni – концентрация свободных носителей в собственном полупроводнике. Поэтому в равновесном состоянии, то есть при отсутствии внешних воздействий на p – n переход, концентрации основных носителей nno и ppo вдали от границы p – n перехода будет определяться выражениями:
 ; ; | (2) |
 , , | (3) |
где индексы n и p внизу символа концентрации означает принадлежность данной концентрации к n – или p – области p – n перехода. Индекс «o» означает равновесное состояние p – n перехода.
Равновесные концентрации неосновных носителей pno и npo можно определить из известных соотношений для невырожденного*) примесного полупроводника:
 . . | (4) |
Следует отметить, что, несмотря на преобладание электронов в n – области, а дырок в р – области, в целом эти области электронейтральны, поскольку заряд основных носителей скомпенсирован противоположным зарядом ионизированных атомов примеси и неосновных носителей.
Вследствие различной концентрации электронов и дырок в разных областях электронно – дырочного перехода через границу этих областей происходит диффузия основных носителей. Электроны из n – переходят в р – область и в n – области вблизи границы образуется нескомпенсированный положительный заряд ионов донорной примеси. Аналогично в p – области вблизи границы образуется отрицательный объёмный заряд ионов акцепторной примеси (рис. 2).
Рис. 2
В образующемся слое объёмного заряда возникает электрическое поле Eк, которое препятствует процессу диффузии. В результате возникает стационарное состояние, характеризующееся наличием области пространственного заряда (ОПЗ) определенной ширины. Эта область называется обедненной областью, так как подвижные носители выводятся из неё электрическим путем. Эту область называют также запорной областью, поскольку существующие в ней поле препятствует диффузии основных носителей. Эта область обладает высоким сопротивлением. Двойной слой пространственного заряда вызывает разность потенциалов между n – и р – областями, которая называется контактной разностью потенциалов и обозначается jк.
Ток, вызванный движением носителей под действием электрического поля Е, называется дрейфовым.
 , , | (5) |
где n, p – концентрации, μn, μp – подвижности электронов и дырок, соответственно, e – заряд электрона (здесь и далее буквой J обозначена плотность тока).
Ток, обусловленный градиентом концентрации носителей, называется диффузионным.
 , , | (6) |
где Jдиф – плотность диффузионного тока, Dn, Dp – коэффициенты диффузии электронов и дырок.
Полный ток через p – n переход равен сумме дрейфовой и диффузионной составляющих.
 | (7) |
Электрическое поле Ек контактной разности потенциалов в ОПЗ является ускоряющим для неосновных носителей и вызывает их дрейфовое движение через р – n переход, то есть электрический ток.
В равновесном состоянии разность потенциалов устанавливается такой величины, что диффузионный ток основных носителей и дрейфовый ток неосновных носителей взаимно скомпенсированы и в целом ток через р – n переход отсутствует.
Потенциальный барьер р – n перехода
На рис. 3 показаны энергетические диаграммы невырожденных примесных полупроводников n – и р – типа (Ed и Ea – примесные уровни).
Рис. 3
Уровни Ферми EFn и EFp на этих диаграммах находятся в разных местах запрещенной зоны Eg. При электрическом контакте этих полупроводников уровни Ферми в них, как известно, должны совместиться (рис. 4). В результате произойдет излом нижней EV и верхней Ec границ запрещенной зоны, поскольку относительные энергетические расстояния внутри полупроводников n – и p – типа должны сохраняться. Дно зоны проводимости 
Это повышение уровня Ec происходит на некотором расстоянии d, равном ширине ОПЗ и соответствует энергетическому барьеру ejк или потенциальному барьеру jк для электронов, переходящих из n – область в p – область, то есть для основных носителей. Такой же величины барьер будет иметь место и для дырок, переходящих из p – области в n – область (энергия для дырок отсчитывается вниз на рис. 4).
Рис. 4
Величину jк можно найти из соотношений
 , , | (9) |
 | (10) |
где Nc – эффективная плотность состояний в зоне проводимости, к – постоянная Больцмана, Т – абсолютная температура.
Поделив (9) на (10) и прологарифмировав, получим
 , , | (11) |
где 
Если к р – и n – областям присоединить металлические контакты (которые должны быть омическими, то есть невыпрямляющими), как показано на рис. 5, то к р – n переходу можно прикладывать внешнее напряжение U. При отсутствии внешнего напряжения на переходе устанавливается потенциальный барьер jк и тока через р – n переход, как уже отмечалось, нет, поскольку диффузионные переходы основных носителей компенсируются дрейфовыми переходами неосновных носителей.
Рис. 5
При приложении к р – n переходу внешнего напряжения U оно практически всё падает на ОПЗ, так как она обеднена носителями заряда и имеет высокое сопротивление.
Если к р – области прикладывается положительный потенциал, а к n – области – отрицательный (рис. 5,а), то говорят, что внешнее напряжение приложено в прямом направлении. При этом поле, создаваемое внешним напряжением, направлено противоположно внутреннему полю и потенциальный барьер понижается:
Это приводит к увеличению диффузионных потоков основных носителей, поскольку пониженный потенциальный барьер может преодолевать большее число носителей. Дрейфовые потоки неосновных носителей, наоборот, уменьшаются вследствие снижения электрического поля в переходе. Во внешней цепи возникает электрический ток, называемый прямымтоком. Таким образом, прямой ток обусловлен основными носителями.
Если внешнее напряжение приложено в обратном направлении (рис. 5,б), то поле этого напряжения совпадает по направлению с внутренним электрическим полем и потенциальный барьер р – n перехода для основных носителей увеличивается
Это приводит к резкому снижению диффузионных потоков основных носителей и некоторому увеличению потоков неосновных вследствие роста электрического поля в ОПЗ. Равновесие нарушается и во внешней цепи возникает ток, называемый обратным током и направленный противоположно прямому току. Таким образом, обратный ток обусловлен неосновными носителями.